https://www.elinfor.com/knowledge/what- … -2-p-11051
13 nanometers of wavelength.
air (gas) can interfere with EUV, so the production process has to be in a vacuum environment.
The energy and destructiveness of EUV light are extremely high.
the mechanical action is accurate to the point where the error is measured in picoseconds.
the other two major micro- projector equipment factories, Nikon and Canon in Japan, have abandoned development.
---
http://www.dailycomm.ru/m/47311/
Taiwan Semiconductor Manufacturing Company (TSMC)
На 2019 год расходы в размере 10-11 млрд долларов.
80% этих инвестиций пойдет на развитие производства 7-, 5- и 3-нм микросхем.
3,98 млрд долларов - капитальные вложения в обновление и расширение мощностей
https://www.elinfor.com/news/tsmc-purch … ed-p-11016
TSMC, has ordered 18 EUV lithography machines from ASML in Netherlands
(Twinscan NXE:3400B, ASML EUV lithography machine, $1.2 hundred million per unit)
with $2.2 billion for the second generation 7nm mass production
in order to get further advantages in 7nm process competition
ASML can only produce 30 EUV lithography machines this year. If it is true, TSMC takes more than a half of ASML’s annual capacity.
начался выпуск 7-нм решений второго поколения с применением EUV-литографии (Во втором квартале 2019)
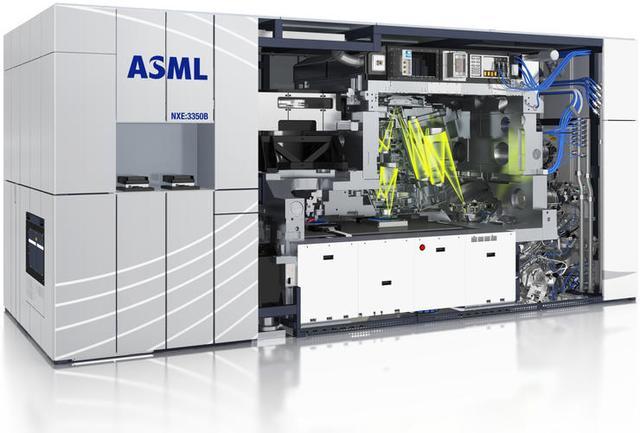

High-end mask aligner is the most sophisticated instrument around the globe and is know as the flower of mordern optical industry. Potoetching decides precision of semiconductor circurt, power dissipation and performance of chips. As the most advanced mask aligner, EUV is the only equipment to produce the processing below 7nm.
mask aligner usually costs between $30 million and $5 hundred million.
ASML owns 90% high-end mask aligner market
YMTC and SMIC in China bought an ASML machine respectively which costs $1.78 hundred million in total
https://www.elinfor.com/news/mask-align … ns-p-10931
It is convinced that China will be farther in chips and will get rid of the destiny relying on inported chips, and really make chips by itself.
---
https://habr.com/ru/post/398967/
ASML с несколькими партнёрами начали работу над EUVL в конце 1990-х (т.е. потребовалось 20 лет исследований)
Отказ от линз (EUV поглощается стеклом) в пользу зеркал.
Первая попавшаяся полированная поверхность не обладала бы нужной отражательной способностью. брэгговские отражатели — многослойные зеркала. В идеале получите зеркало с 70% отражаемостью, значит каждая пара зеркал вдвое ослабляет излучение.
Задача отклонения излучения, сбор нескольких отражений в одно достаточно сильное.
Сканеру может понадобиться десяток зеркал для перенаправления света от источника до маски, которая сама тоже является зеркалом, и потом на подложку. После прохождения пути от начального света может остаться всего 2%.
One of the most critical components, the mirror made by Zeiss, Germany
The size of the defect can only be measured in Picometer.
Получение яркого EUV-излучения. Самый экономный способ - использование плазмы. Подвергнуть нужный материал воздействию достаточно мощного лазера или электрического тока, этим отделить электроны от атомов. Результирующая плазма будет излучать EUV, а разогретая материя – охлаждаться. Лазерный свет попадает на быстрый поток крохотных капель олова. Один из ведущих разработчиков источников света, компания Cymer, смогла создать источник, выдающий 11 Вт на постоянной основе. ASML купила Cymer за €3,1 млрд. в 2013 году.
Если давать предварительный импульс перед основным лазером, каждая капля олова расплющивалась в диск, и тем самым увеличивалась площадь поверхности для взаимодействия с импульсом основного лазера.
Эта технология увеличила выход преобразования из плазмы в EUV с 1% до 5%. Благодаря ей и другим оптимизациям достигается мощности в 200 Вт.
Ещё один разработчик источников света, Gigaphoton, тоже сообщил о большом прогрессе.
там, где света от источника входит в сканер, его мощность составляет 250 Вт. Такое количество света позволит машине обрабатывать порядка 125 подложек в час. Это число находится на уровне желаемого количества для массового производства, и меньше в два раза по сравнению с современными машинами, работающими с 193 нм.
Чем меньше света доходит, тем дольше подложке нужно оставаться в сканере. На на фабрике время = деньги. Для коммерческого использования технология должна конкурировать по стоимости с существующими методами литографии. Потери на отражения должны быть скомпенсированы большой яркостью источника света. Яркость источника, изготовленного нидерландской компанией ASML Holding, приближается к достаточной для коммерческого применения. ASML поставляет EUV-сканеры, которые будут готовы к массовому производству сверхсовременных микропроцессоров и памяти уже в 2018 году.
EUV Cymer используют плазму, получаемую при помощи лазера. 50 000 микроскопических капель ультрачистого олова в секунду устремляется через вакуумную камеру, и каждая из них освещается светом углекислотного лазера, прошедшего через несколько усилителей, изначально разработанных для резки металла. Когда импульс лазера встречается с каплей, она разогревается до состояния плазмы и излучает EUV. Собирающее зеркало отражает свет и отправляет его в сканнер. Чтобы на зеркале не скапливались остатки олова, его постоянно продувают водородом.

"EUV не может путешествовать по воздуху, и его нельзя сфокусировать линзами или обычными зеркалами"
"На 13,5 нм свет поглощается множеством материалов. Даже воздух «абсолютно чёрный», и поглощает всё излучение"
Сегодня зеркала в EUV-машинах состоят из 40 пар перемежающихся кремния и молибдена, и каждый из слоёв имеет в толщину всего несколько нанометров. Разработавшая зеркала компания Zeiss изготавливает их с высокой точностью.
технологические трудности:
1) защита маски, поверхности трафарета, который будет отпечатан на подложке. Тут опять возникает вопрос отражающей способности.
в ASML исследуют вопрос изготовления пелликулы, способной противостоять EUV-излучению. И она должна быть прозрачной, что ещё труднее. Поскольку маски EUV не прозрачные, а отражающие, свет должен пройти через пелликулу два раза – внутрь и наружу (гравитацию как будто не для них придумали...)
2) необходимо найти возможность изготавливать маски без дефектов, а также возможность проверять отсутствие дефектов масок.
Inpria - стартап по EUV-резистам, Эндрю Гренвиль [Andrew Grenville] - генеральный директор.
резист из небольших компонентов оксида олова, поглощающих EUV в пять раз лучше и создающих шаблоны без усиления.
Современные химически усиливаемые резисты изготавливаются из полимерных цепочек молекул, умножающих эффект приходящих фотонов. Но эти материалы плоховато поглощают EUV
Зафиксированное изображение немного расплывается, поскольку реакция усиления света проникает в материал.
Цена на новый агрегат от ASML превышает €100 млн., это вдвое дороже предыдущих.
может потреблять около 1,5 МВт
Отредактировано Лис (2019-05-16 11:35:32)